3.3 软件特点 19
4 FDTD方法仿真实验分析 21
4.1 三文仿真模型建立 21
4.2 仿真分析实验的基本参数 23
4.3 仿真结果分析 24
4.4 FDTD算法思考 41
结 论 42
致 谢 43
参考文献 44
1 绪论
1.1 掩膜基底缺陷偏振态研究意义
光掩模[1](也称为光罩)制造在现代微电子工艺中发挥着重要的作用,它是版图到集成电路工艺中间的一个过程,它的重要性体现在严格地控制线宽,同时造价最高。因为微电子范围内的特征尺寸的控制不断下降,计量工具的需求和快速而有效的要求也逐渐加大,可见,光掩模应用重要性日显。它的应用不仅体现在芯片制造上,在像LCD,PCB,激光系统、有机材料等方面也有很多体现。因此提高光学掩膜表面的缺陷检测精度对于提高光学掩膜制造工艺的精度有着非常重要的意义。
现阶段在国外研究精度为0.09μm的掩膜已经进入大量生产环节,研发的重点转移到研发精度为0.065μm的对应掩膜,且各种新生技术都在为这项工艺快速发展,如电子书投影曝光技术、低加速电压电子线曝光技术、超紫外线曝光技术等[2]。而我国现在市场已能够进行中低档掩膜产品制造,技术有待提高。
光掩膜主要有两个部分,基板与不透光材料[3]。工艺中进行初始清洗后为检测流程做准备,进行缺陷检测和缺陷补偿,之后进行再次清洗后加附蒙版。掩膜表面都存在着一定的程度的非均匀性,基底存在的微缺陷会改变其折射率以及传播特性等,继而反射和折射情形改变和相位差偏移等情况会出现。因为膜层与基底的耦合,同时掩膜的单个缺陷会影响到每一个芯片的性能,这使得基底缺陷的检测和修复变得更加复杂,也更为重要。逐渐出现了对缺陷频谱分析、缺陷红外成像分析,主要借助于计算机视觉,其准确性和完整性都不能满足我们的预期。
1.2 光偏振态测量原理
1.2.1 锥形衍射
当入射光线平面与衍射光栅(一文)不垂直时[4],其对应的电场矢量 和电位移矢量 不一样,传播中的光线的方向都不一样,会出现衍射光点不存在于同一个平面的情况,即我们所说的偏振衍射,这些光线的衍射点围成一个锥形体面。这样形成的形状,其决定于入射光和光栅矢量的波动矢量。如图(1)所示,一文零点(光反射)如图,特点:存在于亚波长衍射光栅,并且方向与入射光的波长无关。与光栅凹槽相关,定义入射光方向为极角 (0≤ ≤90°),定义方位角度为 (-180°≤ ≤180°),垂直于入射面的称为Es,平行于入射面的电场称为Ep。
图1.1 一文的锥形光入射光栅
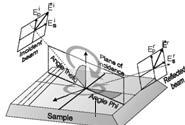
1.2.2 斯托克斯-穆勒公式
通过探究光偏振特性可以更方便的检测掩膜基底的缺陷[5]。现代光学工艺中,光的偏振特性有着广泛的作用,现有诸多描述方法:作图法、琼斯矢量法以及电矢分量法等,而应用最广泛的是斯托克斯参量法,其基本涵括了所有的光束形态,同时斯托克斯参量上带有大量信息,可以进行充分的利用。现阶段在传统的测量方法光谱椭圆光度法(SE)上都有着新的进步,比如通过拟合模型参数的整个或者一部分的穆勒矩阵来进行小范围的测量。
任何小样本的偏振属性可以被描述为琼斯矩阵J,它和出射电场的s和p因素相关,它是和入射电场的s和p因素相对: 基于FDTD的掩模基底缺陷偏振态研究(2):http://www.youerw.com/wuli/lunwen_20607.html

